211422198804190011
摘要:电子元器件失效分析是通过对失效件的解剖、观察、分析研究,找出失效机理,查明造成失效件故障的根本原因,进而提出电子元器件改进措施,提高产品的良品率及可靠性。在电子元器件的设计、生产、测试以及应用等环节中,都离不开失效分析。随着电子元器件功能的多样化,外观的微型化,对于电子元器件失效分析能力的要求越来越高,如何对失效位置进行准确的定位成为失效分析的关键所在[1]。
关键词:电子元器件失效分析 扫描电子显微镜 电压对比
一、引言
在实际的失效分析过程中可以发现,电子元器件的失效模式多种多样,不同种类的器件有着各自不同的失效模式,即使是同一类型器件,在不同的环境条件下产生的失效模式,也会表现出截然不同的失效模式。一般失效分析的流程为:确认失效模式,检查外观,无损检测,电性能测量,启封,失效位置定位。当集成电路进入到纳米工艺,器件的晶体管集成度大幅增加,如果无法对失效点进行准确的定位,找出故障的原因无异于大海捞针。所以在整个失效分析流程中,失效位置的定位无疑是重中之重。
本文首先对扫描电子显微镜的原理及功能进行介绍,对电压对比定位技术进行分析,最后,结合实际失效分析中的具体应用,对电阻、集成电路及混合电路等具有代表产品的失效定位问题进行深入研究。该研究取得的成果已用于实际生产,极大地提高了失效分析的成功率,对后续的电子元器件失效分析及质量控制工作有一定的借鉴意义。
二、SEM电压对比定位技术
SEM一般应用在高放大倍数的微观观察和分析上。对于电子元器件失效分析而言,SEM主要的应用方向之一是使用电子束让样品表面形成的电压对比效应,从而对故障产品进行缺陷的观察及定位。
SEM的电压对比技术分为被动电压对比和主动电压对比,一般主动电压对比需要外加电压,而SEM的电压对比技术属于被动电压对比,不需要施加外来电压,而是根据样品自身特性来判别是否异常。一般样品可分为两类:一类为悬空结构,另一类为接地结构,接地结构的样品具有良好的接地特性,电子束入射到样品表面后,在样品表面激发出二次电子,同时样品表面会产生与之相等的正电荷。图二所示为样品的悬空结构及接地结构。当样品接地时,正电荷就会被导出,不影响二次电子的散射,这样二次电子就很容易地被探头接收,并形成发亮的图形;对于悬浮结构,正电荷无法导出时,正电荷会抑制二次电子的散射,所以探头接收比较困难,并形成较暗的图像,这就是简单电压对比的形成原理。
在实际情况中,图像表现为发亮或者发暗还与电子束的加速电压有关,在实际应用中,加速电压在1~3kV之间内[3],器件表面才会堆积正电荷,在其它区间则堆积负电荷,堆积电荷情况还与SEM设备本身相关,设备的样品台接地情况,使用时的真空状态,电流值大小等因素均影响电荷的累积。若是加速电压在20~30kV之间时,器件表面还会累积较多的负电荷,导致器件表面形成高亮的图像。
四、扫描电子显微镜电压比对技术在电子元器件失效分析中的应用
某型号电阻在使用过程中,发现电阻阻值增大,在光学显微镜下,无法分辨电阻膜异常,用扫描电子显微镜对电阻膜表面进行观察,电阻膜表面存在一处高亮现象,对高亮位置进行能谱分析,该处存在腐蚀性介质Cl元素,对通过观察及能谱分析,故障位置定位至该处电阻膜腐蚀,导致电阻膜宽度变窄进一步造成阻值增大。图七所示为SEM下电阻表面形成高亮区域。

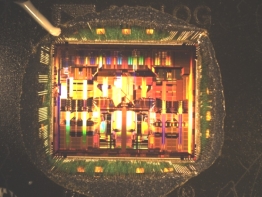
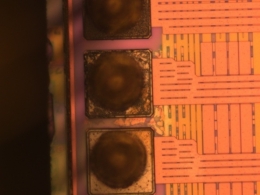
光学显微镜下芯片形貌

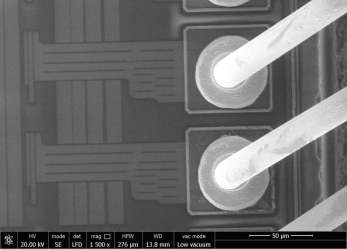
SEM下芯片表面形成较暗区域
图中是失效分析中,使用电压对比技术方法验证失效分析结论。对于某型号集成电路,在光学显微镜下观察芯片,芯片相邻的内键合点之间存在明显的多余物搭接现象,多余物位于钝化层的下面,从其形貌判断,多余物应为金属迁移形成的迁移产物,用扫描电子显微镜对电路进行观察,多余物位于钝化层底部,无法进行观察,但键合点之间无电荷累积,其它键合点之间存在明显的电荷累积,形成高亮状态。图八所示为SEM下芯片表面形成较暗区域。

电压比对对比图(a图),TEM照片(b图)
这是一个电路内部通孔链测试结构,测试中发现有断路的现象。分析中使用10kV加速电压观察整个结构,发现有明显的亮、暗异常。显然,问题就出在亮、暗的交界处,后续使用FIB及TEM分析可得,通孔底部开路,从而导致整个结构出现断路的测试现象[4]。图九所示为电压比对对比图(a图)及TEM照片(b图)。
解剖观察后,发现内部一只电容存在短路,但电容外部未表现出异常,分析中使用20kV加速电压观察整个结构,未发现有明显的亮、暗异常,可以定位为该电容某处存在漏电,经扫描电子显微镜进一步对电容侧边进行观察,输出端电容边缘已经超出陶瓷基板,电容侧边与其外键合区域的金导带间已经搭接且存在烧毁痕迹。而电容器被短接的原因是由于电容芯片边缘超出烧结区域,导致电容侧面与电容器外键合区域的金导带几乎搭接,电容器芯片侧面与外键合区金导带打火并形成导电通路。图十所示为电容上电极及电容边缘形貌。
三、结语
失效分析作为解决问题、探寻失效原因以及提高良率的重要手段显得越来越重要。而作为失效分析中最重要的一环,定位技术也在分析压力及需求的驱动下有了长足的进步。对于如今的大规模集成电路而言,要在数以千万计的器件中找出缺陷的位置,必须以精确的定位为前提。只有精确的失效点定位,后续的分析才有章可循,才有可能找到最终的失效机理和失效原因。
四、参考文献
1. 唐民,张素娟.先进成像技术在失效分析中的应用[J].半导体技术:2001,26(2):50-53.
2. 汪建民.材料分析[M].台湾:中国材料科学学会,1989:175-236.
3. Rosenkranz R. Failure localization with active and passive voltage contrast in FIB and SEM[J]. Journal of Materials Science: Materials in Electronics, 2011, 22(10): 1523-1535.
4.孔学东,恩云飞,电子元器件失效分析与典型案例,国防工业出版社